

窒素ラジカル源としての放電スペクトル
RF電力:400W
このプラズマ源はICPタイプのRF高密度プラズマにより、各種原料ガスを処理し、成膜実験、エッチング実験などにご使用頂けます。
プラズマ室は石英製になっており、また無電極放電により金属汚染の少ないプロセスが可能です。
活性ガス導入時でも長時間安定動作が行え、クリーンな原子・ラジカルビームなどを得ることができます。
マイクロ波プラズマ源とのプラズマ密度や給電方法等の違いについては、マイクロ波プラズマ源とRFプラズマ源の違い①をご覧下さい。
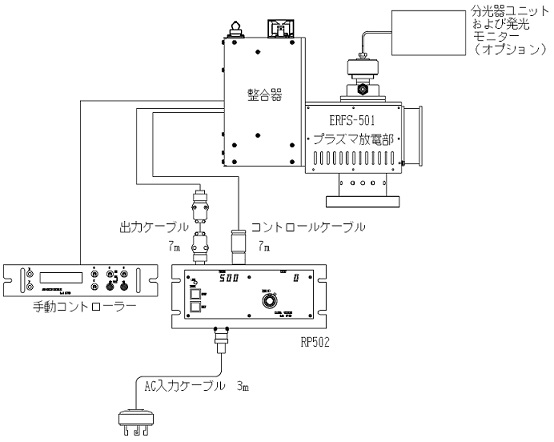
| 型式 | ERFS-501 |
| RF出力 | 0~500W 13.56MHz ± 1kHz |
| 整合器 | 自動整合器 (手動コントローラー添付) |
| ベーキング温度 | 最高 150℃ (ケーブル、整合器部分を除く) |
| プラズマ励起方法 | コイル誘導結合 (ICP) |
| 放電室材質 | 透明石英製 |
| 最大出射口径 | φ28mm |
| ガス導入系 | 1/4 VCRTM オス |
| 冷却方法 | 強制空冷 |
| 接続フランジ | VG80 又は CF114 |
| 質量 | 約9.5kg |
| 型式 | RP-502 |
| 電源入力 | 単相AC100~240V 50/60Hz |
| 最大消費電力 | 750W |
| 出力周波数 | 13.56MHz ± 1kHz |
| 出力電力 | 0~500W (500W 連続) |
| 出力インピーダンス | 50Ω (N型コネクター) |
| リモート出力制御 | 0~5V DC外部入力によるリニア制御 |
| 出力表示モニタ出力 | デジタル表示 0~5V DCリニア出力 |
| 冷却方法 | 強制空冷 |
| 保護機能 | 過負荷保護機能 高反射による出力制限 外部インターロック |
| 質量 | 5.0 kg |
| 標準添付品 | 出力ケーブル (7m)、電源ケーブル (3m) |
| プラズマ源 | バリアブルリークバルブ、MFC | ガス導入系に制御機器が増設可能です。
ガス種、ガス流量などご注文時にご相談下さい。 |
| 分光器 | 放電スペクトルをモニターします。 | |
| RF電源 | パルス駆動 (100Hz~20kHz) | 外部信号による ON/OFF パルス制御が可能です。 |
| 入力100V | 入力電源を 100Vでご使用の場合はご指定下さい。 | |
| ケーブル | ケーブル延長 ※ご注文時お問い合わせ下さい。 |
電源本体、整合器間の出力、コントロールケーブルの延長 |
規格品以外にも、特殊仕様の製作も可能です。下記よりお問い合わせください。
 お問い合わせ >
お問い合わせ >